
01
認(rèn)識功率器件(jiàn)
1.1 功率半導體器(qì)件在工業 、消費 、軍事(shì)等領域都有著廣泛應用(yòng) ,具有很高的戰略地位,下麵我們從一張圖看功率(lǜ)器件的全(quán)貌:

1.2 功率半導(dǎo)體器件又可根據對電路信(xìn)號(hào)的控程(chéng)度分為全(quán)型 、半控型及不可;或按驅動電路信號(hào) 性質分(fèn)為電壓驅動型 、電流驅動型(xíng)等(děng)劃分類別 電流驅動型(xíng)等劃分類別 電流驅動型(xíng)等劃分類別 。

1.3 不同功率半導體器件 ,其承受電壓 、電(diàn)流容量(liàng) 、阻抗能力 、體積大小等特(tè)性(xìng)也(yě)會不同 ,實際使用中(zhōng) , 需要根據不同領域 、不同需(xū)求來選(xuǎn)用合適的器(qì)件。

1.4 半導體行業從誕生至今 ,先後經曆了(le)三代材料的變更程 ,截至目(mù)前(qián) ,功率半導體(tǐ)器(qì)件領域仍主要采 用以 Si 為代表的第一半導體材(cái)料 。

1.5 匯總下半控型和全控型功(gōng)率器件的特性

02
認識(shí)MOSFET
2.1 MOS管具有輸入阻抗高(gāo)、噪聲低、熱穩定性(xìng)好(hǎo);製造工藝簡單、輻射強,因而通常被用於放大電路或(huò)開關電(diàn)路;
(1)主要選型參數(shù):漏源電壓VDS(耐壓),ID 連續漏電流(liú),RDS(on) 導(dǎo)通電阻,Ciss 輸入電容(結電容),品質因數FOM=Ron * Qg等。
(2)根據不同的工藝又分為
Trench MOS:溝槽型(xíng)MOS,主要(yào)低壓領域100V內;SGT (Split Gate)MOS:分裂柵MOS,主要中低壓領域(yù)200V內;SJ MOS:超結(jié)MOS,主要在(zài)高(gāo)壓領域 600-800V;
在(zài)開關電源中(zhōng),如漏(lòu)極(jí)開路電路,漏極原封不動地(dì)接負載,叫開路漏極(jí),開路漏極電路中不管負載接(jiē)多(duō)高的電壓,都能夠接通和關斷負載電流。是理想的模擬開關器(qì)件。這就是MOS管(guǎn)做開關器件的原理(詳細請關注(zhù)作者其他MOS詳解)。
2.2 從市場份額看,MOSFET幾乎都集中(zhōng)在國際(jì)大廠手中,其中英飛淩(líng)2015年(nián)收購了IR(美國(guó)國際整(zhěng)流器公司)成為行業龍頭,安森美(měi)也在2016年9月完成(chéng)對仙(xiān)童半導體的收購後,市占率躍升至第二,然後銷售排名分別是瑞薩、東(dōng)芝、萬國(guó)、ST、威世、安(ān)世、美格納等等;
與活躍於中(zhōng)國大(dà)陸的國際廠商(shāng)相比,國產(chǎn)企業優勢不明顯,但這不能說國產(chǎn)沒有機會,中國大陸是世界上產業(yè)鏈最齊全的經濟活躍區,在功率半導體領域活躍著一批本土製造企業,目前(qián)已基本完成產業鏈布局,且處於快速發展中;特別是MOSFET領域,國產在中低壓領域替換(huàn)進口品牌潛力最大,且部(bù)分國產、如士蘭、華潤微(中航)、吉林華(huá)微等都在努力進入世界排名;
03
主流MOS管品牌
3.1 MOS管分為幾大係列:美係(xì)、日係、韓係、國產。
美係:英飛淩、IR,仙(xiān)童,安(ān)森美,ST,TI ,PI,AOS美(měi)國萬代半導體(tǐ)等;
日係:東芝,瑞薩,ROHM羅姆等;
韓係:SEMIHOW,美格納,KEC,AUK,信安,KIA
國產:吉林華微電(diàn)子股份有限公司,揚州揚傑電子科技股份有限(xiàn)公司,
杭州士蘭微電子(zǐ)股份有限公司,華潤(rùn)微電子(重慶)有限公司,無錫新潔能,西安後(hòu)裔,深圳銳駿半導體,無(wú)錫華潤華晶微電(diàn)子有限公司,江蘇東晨電子科(kē)技有限公司(前身東光微),東微半(bàn)導體,威兆半導體,蘇州矽能,無錫市芯途(tú)半導體有限公司
台係:ANPEC,CET華(huá)瑞,友順UTC,台灣綠星等;
04
MOS管封裝分類
按照安裝在PCB板上(shàng)的方(fāng)式來(lái)劃分,MOS管封裝主要有兩大類:插(chā)入式(Through Hole)和表麵貼裝式(Surface Mount)。
插入式就是MOSFET的管(guǎn)腳穿過PCB板的安(ān)裝孔並焊(hàn)接(jiē)在PCB板上。常見的插入式(shì)封裝有:雙(shuāng)列直插式封(fēng)裝(DIP)、晶體管外(wài)形封裝(TO)、插針網格(gé)陣列封裝(PGA)三種樣式。

插入(rù)式封(fēng)裝
表麵貼裝則是MOSFET的管腳及散熱法蘭焊(hàn)接在PCB板表麵的焊(hàn)盤上。典型表麵貼裝式封(fēng)裝有:晶體管外(wài)形(D-PAK)、小外(wài)形晶體(tǐ)管(guǎn)(SOT)、小外形封裝(SOP)、方形扁平(píng)式(shì)封裝(QFP)、塑封有引線芯片載體(PLCC)等。
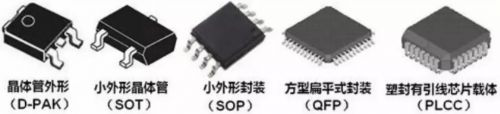
表(biǎo)麵貼裝(zhuāng)式封(fēng)裝(zhuāng)
隨著技術的發展,目前主板、顯(xiǎn)卡等(děng)的PCB板采用直插式(shì)封裝(zhuāng)方式的越(yuè)來越少,更多地(dì)選用了表麵貼裝式封裝方式。
1、雙列直插式封裝(DIP)
DIP封(fēng)裝有兩排引腳,需要插入到(dào)具有DIP結構的芯片插座(zuò)上,其派生方式為SDIP(Shrink DIP),即緊縮雙入線封裝,較DIP的針腳(jiǎo)密度高6倍。
DIP封裝結構形式有:多層陶瓷雙列直插式DIP、單層陶瓷雙列直插(chā)式DIP、引線(xiàn)框架式DIP(含玻璃陶(táo)瓷封接式、塑料包封結構式、陶瓷低熔玻璃封裝式(shì))等。DIP封裝的特點是可以(yǐ)很方便地實現PCB板的穿孔焊接,和主板有很好的兼容性。
但由於其封裝(zhuāng)麵積和厚度都比較大,而且(qiě)引腳在插拔過程中很(hěn)容易被損壞,可靠性較差;同(tóng)時由於受(shòu)工藝的影響,引腳一(yī)般都不(bú)超(chāo)過100個,因此在電子產業高度(dù)集成化過(guò)程中,DIP封裝逐漸退出了曆史舞台。
2、晶體(tǐ)管外形封裝(TO)
屬於早期的封裝規格,例如(rú)TO-3P、TO-247、TO-92、TO-92L、TO-220、TO-220F、TO-251等都是插(chā)入式封裝(zhuāng)設計。
TO-3P/247:是中高壓(yā)、大電流MOS管常用的封裝形式,產品具有耐壓高、抗擊穿能力強等特點。
TO-220/220F:TO-220F是全塑封裝,裝到(dào)散熱(rè)器(qì)上時(shí)不必加絕緣墊;TO-220帶金(jīn)屬片與(yǔ)中間腳相連,裝散熱器時要加絕緣墊。這兩種封裝樣式的MOS管外觀差不多,可以互(hù)換使用。
TO-251:該封裝產品(pǐn)主要是為了降低成本和縮小(xiǎo)產品(pǐn)體積,主要應用於中壓大電流(liú)60A以下、高壓7N以下環境中。
TO-92:該封裝隻有低壓MOS管(電流10A以下、耐壓(yā)值60V以下(xià))和高壓1N60/65在采用,目的是降低成本。
近年來,由於插入式封裝工藝焊接成本高、散熱性(xìng)能也(yě)不如貼片式產品,使得表麵貼裝(zhuāng)市場需求量不(bú)斷增大,也使(shǐ)得TO封裝發展到(dào)表麵貼裝式封裝。TO-252(又(yòu)稱之為D-PAK)和(hé)TO-263(D2PAK)就是表麵(miàn)貼裝封裝(zhuāng)。

TO封裝產品外觀
TO252/D-PAK是一種塑封貼片封(fēng)裝,常用於功率晶體管、穩壓芯片的封裝,是(shì)目前主流封裝之一(yī)。
采用(yòng)該封裝方式的MOSFET有3個電極,柵極(jí)(G)、漏極(jí)(D)、源極(S)。
其中漏極(D)的引腳被剪斷不用,而是使(shǐ)用背麵(miàn)的散(sàn)熱板作(zuò)漏極(jí)(D),直接焊接在PCB上(shàng),一(yī)方麵用於輸出大(dà)電流,一方麵通過PCB散熱;所以PCB的D-PAK焊盤有三處,漏極(D)焊盤較大。其封裝規範如下:

TO-252/D-PAK封裝(zhuāng)尺寸(cùn)規格
TO-263是TO-220的一個變種,主要是為了提高生產效率和散熱而(ér)設計,支持極高(gāo)的電(diàn)流和電壓,在150A以下、30V以上的(de)中壓大電流MOS管中較為多見。
除了D2PAK(TO-263AB)之外,還包括TO263-2、TO263-3、TO263-5、TO263-7等樣式,與TO-263為從(cóng)屬關係(xì),主要是引出腳數量(liàng)和距離不同。
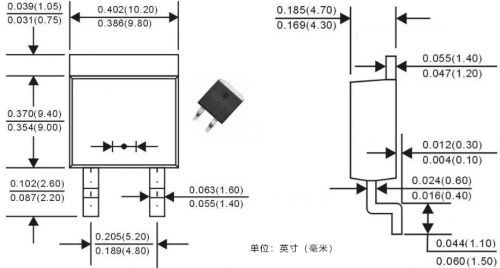
TO-263/D2PAK封裝尺寸規格
3、插針網格陣列封裝(PGA)
PGA(Pin Grid Array Package)芯片內外有多個方陣形的插(chā)針,每個方陣形插針(zhēn)沿芯(xīn)片的四周間隔一定(dìng)距離排列,根據管(guǎn)腳數目的多少,可以圍成(chéng)2~5圈。安裝時,將芯片插入專門(mén)的PGA插(chā)座即可,具有插拔方便且可靠性高的(de)優(yōu)勢,能適應更高的頻率。

PGA封(fēng)裝樣式
其芯片基板多數為(wéi)陶瓷材質,也有部分采用特製(zhì)的塑料樹脂來做基板,在工藝上,引腳中心(xīn)距通(tōng)常為2.54mm,引腳數從64到447不等。
這種封裝的(de)特點是,封裝麵積(體積(jī))越小,能(néng)夠承受的功(gōng)耗(性(xìng)能)就越低,反之則越高。這種封裝形式芯片在早期比較多(duō)見,且多用於CPU等大功耗產品的(de)封裝(zhuāng),如英特(tè)爾的80486、Pentium均采用此封裝樣式;不大為MOS管廠家所(suǒ)采納。
4、小外形晶體管封裝(SOT)
SOT(Small Out-Line Transistor)是(shì)貼片型(xíng)小功率晶體管封裝,主要有SOT23、SOT89、SOT143、SOT25(即SOT23-5)等,又衍生出SOT323、SOT363/SOT26(即SOT23-6)等類型,體(tǐ)積比TO封裝小。

SOT封裝類型
SOT23是常用的(de)三極管封(fēng)裝形(xíng)式(shì),有(yǒu)3條翼形引腳(jiǎo),分別為集電極、發射極和基極(jí),分別列於元件長邊兩側,其中,發射極(jí)和基極在同一側,常見於小功率晶體管(guǎn)、場效應(yīng)管和帶電阻網絡的複(fù)合(hé)晶(jīng)體管,強度(dù)好,但可焊(hàn)性差,外形如下(xià)圖(a)所示。
SOT89具有3條短引腳,分布在晶體管的一側,另外一側為金屬散熱片,與基極相連,以增加散熱能力,常見於矽功率表麵組裝晶體管(guǎn),適用於較(jiào)高功率(lǜ)的場合,外形如下圖(b)所(suǒ)示。
SOT143具有4條翼形短引腳,從兩側引出,引腳(jiǎo)中寬度偏大的一端為集電極,這類封裝常見於高頻晶體(tǐ)管,外形如下圖(c)所(suǒ)示。
SOT252屬於(yú)大功率(lǜ)晶體管,3條引腳從(cóng)一側引出,中間一條引腳較短,為集電極,與另一端較大的引腳相連,該引腳為散熱作用的銅片,外形如下圖(d)所示。

常見SOT封裝外形比較
主板(bǎn)上常用四端引腳的SOT-89 MOSFET。其規格尺寸如下:
SOT-89 MOSFET尺寸規格(單位:mm)
5、小外形封裝(SOP)
SOP(Small Out-Line Package)是表麵貼裝型封裝之一,也稱(chēng)之為SOL或DFP,引腳從封裝兩側引出呈海鷗翼狀(L字形(xíng))。材料有塑料和陶瓷兩種。
SOP封裝標準有SOP-8、SOP-16、SOP-20、SOP-28等,SOP後麵的(de)數字表示引腳數。MOSFET的SOP封裝多數采用SOP-8規格,業界往往把“P”省略,簡寫為SO(Small Out-Line)。
SOP-8封裝尺寸
SO-8為PHILIP公司率先開發,采(cǎi)用塑料封裝,沒(méi)有散熱底(dǐ)板,散熱不良,一般用於小功率MOSFET。
後逐(zhú)漸派生出TSOP(薄小外形封裝)、VSOP(甚小(xiǎo)外形封(fēng)裝)、SSOP(縮小型(xíng)SOP)、TSSOP(薄的縮小型SOP)等標準規格;其(qí)中TSOP和TSSOP常用於MOSFET封裝。

常用於MOS管的SOP派生規格
6、方形扁平式封裝(QFP)
QFP(Plastic Quad Flat Package)封裝的芯片引腳之間距離很(hěn)小,管腳很細,一般在(zài)大規模或超大型集成電路中采用,其引腳數(shù)一(yī)般(bān)在100個以上。
用(yòng)這種形式封(fēng)裝的芯片(piàn)必須采用(yòng)SMT表麵安裝技術(shù)將芯片與(yǔ)主板焊接起來。該封裝方式(shì)具有四大特點:
①適用於SMD表麵安裝技(jì)術在PCB電(diàn)路板(bǎn)上(shàng)安裝布線;
②適合高頻使用;
③操作方便,可靠性高;
④芯片麵積與(yǔ)封裝麵積之間的比值較小。
與PGA封裝方式一樣,該封裝方式將芯片包裹在(zài)塑封體內,無法將芯片工作時產生的(de)熱量(liàng)及時(shí)導出,製約了MOSFET性能的提升;而且塑封本身增(zēng)加了器件尺寸,不符合半導(dǎo)體向輕、薄、短、小方向發展的要求;另外,此(cǐ)類封裝方式是基於單顆芯(xīn)片進行,存在生產效率(lǜ)低、封裝成本高的(de)問題。
因此,QFP更適於微處理器/門陳列等數字邏輯LSI電路采用(yòng),也適(shì)於VTR信號處理、音響信(xìn)號(hào)處理等模擬LSI電路產品封裝。
7、四邊無引線扁平封裝(QFN)
QFN(Quad Flat Non-leaded package)封裝四邊配置有(yǒu)電極接點,由於無引線,貼裝表現出麵積比(bǐ)QFP小、高度比QFP低的特點;其中陶瓷(cí)QFN也稱為LCC(Leadless Chip Carriers),采用玻璃(lí)環氧樹脂印刷基(jī)板基材的低成(chéng)本(běn)塑料QFN則稱為塑料LCC、PCLC、P-LCC等(děng)。
是一種(zhǒng)焊盤尺寸小、體積小、以塑料作為密封材料的(de)新(xīn)興表麵(miàn)貼裝芯(xīn)片(piàn)封裝技(jì)術。
QFN主要用於集成電路封裝,MOSFET不會采用。不過因Intel提出整合驅動與MOSFET方案,而推出了采用(yòng)QFN-56封裝(“56”指芯片背麵有56個連接Pin)的DrMOS。
需要說明的是,QFN封裝與超薄小外形封裝(TSSOP)具有相同的外引線配(pèi)置,而其尺寸卻比TSSOP的小62%。根據QFN建模數據,其熱性能比TSSOP封裝提高了55%,電性能(電感和電容)比TSSOP封裝分(fèn)別提高了60%和30%。最大的缺點則是返修難度高。
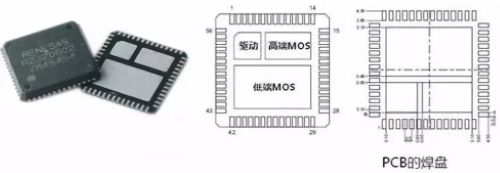
采(cǎi)用QFN-56封裝的DrMOS
傳統的(de)分立式DC/DC降壓開關電源無法滿足對更高(gāo)功耗密度的要求,也不能解決高開關頻率下(xià)的寄生參數影響問題。
隨(suí)著技術的革新與進步,把驅動器和MOSFET整合在一起,構建多芯片模塊已經成為了現實,這種整合方式同時可以節(jiē)省相當可觀(guān)的(de)空間從而提升功耗密度,通過對驅動器和MOS管的優(yōu)化提高電能效率和優質(zhì)DC電流,這就是整合驅動IC的DrMOS。
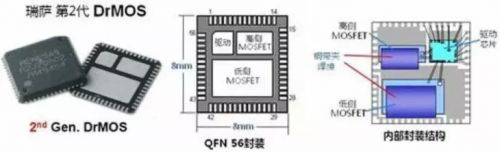
瑞薩第2代DrMOS
經過QFN-56無腳封裝,讓DrMOS熱阻抗(kàng)很(hěn)低;借助內(nèi)部引線鍵(jiàn)合以(yǐ)及銅夾帶設計,可最(zuì)大(dà)程度減少外部(bù)PCB布線,從而降(jiàng)低電感(gǎn)和電阻。
另外,采用的深溝道矽(trench silicon)MOSFET工藝,還能顯著降低傳導、開關(guān)和柵極電荷損耗(hào);並能(néng)兼容多(duō)種控製器,可實現不同的工作模式,支持主動相變換模式APS(Auto Phase Switching)。
除了QFN封裝外,雙邊扁平無引腳封裝(DFN)也是一種(zhǒng)新的電子封裝(zhuāng)工藝(yì),在安森美的各種元器件中得到了廣泛采用,與QFN相比,DFN少(shǎo)了兩邊的引出電極。
8、塑封有引線芯片載體(PLCC)
PLCC(Plastic Quad Flat Package)外形呈正方形,尺寸比DIP封裝(zhuāng)小得多,有32個引腳,四周都有管腳,引腳從封裝的四個側麵引出,呈丁字形,是塑料製品。
其引腳中心距1.27mm,引腳數從18到84不等,J形引腳不易變形,比QFP容易操(cāo)作,但焊接後的外觀(guān)檢查較為困難。PLCC封裝適合用SMT表麵安裝技術在(zài)PCB上(shàng)安裝布線,具有外形尺寸小、可靠性高(gāo)的優點。
PLCC封裝(zhuāng)是比較常(cháng)見,用於(yú)邏輯LSI、DLD(或程邏輯器件)等電路(lù),主板Bioses常采用的這種封(fēng)裝形式,不過目前在MOS管中較少見。

PLCC封裝樣式
主流企業的封裝與改進
由於CPU的低電壓、大電(diàn)流的發展趨勢(shì),對MOSFET提出輸出電流大,導通電阻(zǔ)低,發熱量低散熱快,體積小的要(yào)求。MOSFET廠商除了(le)改進芯片生產技術和工藝外,也不斷改進封裝技術,在與(yǔ)標準外形規格兼容的基礎上,提(tí)出新的(de)封(fēng)裝外形,並為自(zì)己研發的新封裝注冊商標名稱。
1、瑞薩(RENESAS)WPAK、LFPAK和LFPAK-I封(fēng)裝
WPAK是瑞薩開發的一種高熱輻射(shè)封裝,通過仿D-PAK封裝那樣把芯片散熱板(bǎn)焊(hàn)接在主板上,通過主板散熱,使小形封(fēng)裝的WPAK也可以達到D-PAK的輸出電流。WPAK-D2封裝了高/低2顆MOSFET,減小布線電感。
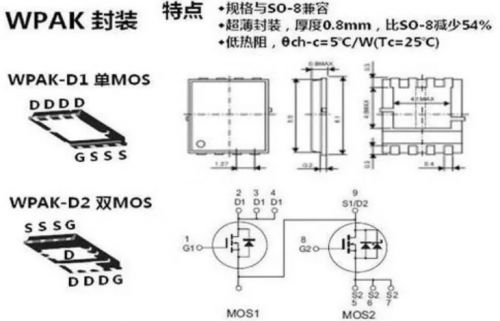
瑞薩WPAK封裝尺寸
LFPAK和LFPAK-I是瑞薩開發的(de)另外2種與SO-8兼容的小形封裝。LFPAK類似D-PAK,但比D-PAK體積小。LFPAK-i是將散熱板向上,通過散(sàn)熱片(piàn)散熱。
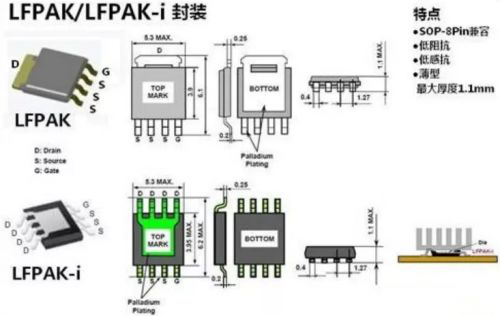
瑞(ruì)薩LFPAK和LFPAK-I封裝
2、威世(Vishay)Power-PAK和Polar-PAK封裝
Power-PAK是威世公司注冊的MOSFET封裝名稱。Power-PAK包(bāo)括有Power-PAK1212-8、Power-PAK SO-8兩種(zhǒng)規格(gé)。
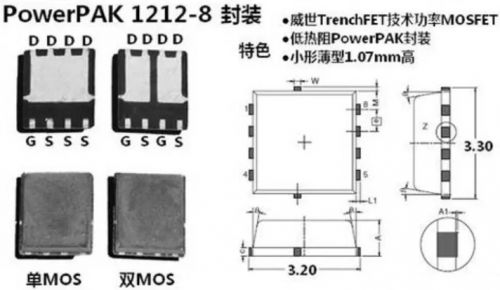
威世Power-PAK1212-8封裝
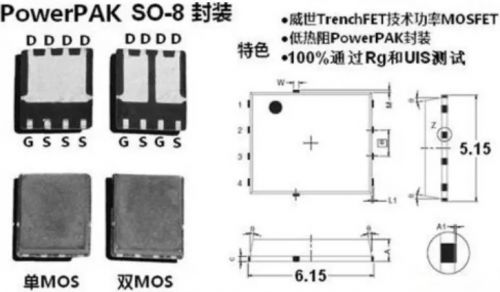
威世Power-PAK SO-8封裝
Polar PAK是雙麵(miàn)散熱(rè)的小形封(fēng)裝,也是威世核心封裝技術之一。Polar PAK與普通的so-8封裝相同,其在封裝的上、下兩(liǎng)麵均設(shè)計(jì)了散熱點,封(fēng)裝內部不易蓄熱,能夠將工(gōng)作電流的電(diàn)流密度提高至SO-8的2倍。目前威(wēi)世已向意法半導體公司提供Polar PAK技術授權。
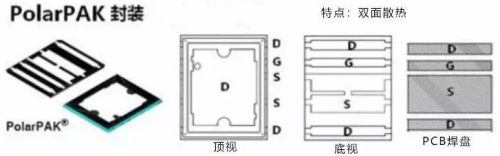
威世Polar PAK封(fēng)裝
3、安(ān)森美(Onsemi)SO-8和WDFN8扁平引腳(Flat Lead)封裝
安美森(sēn)半導體開發了2種扁平(píng)引腳的MOSFET,其中SO-8兼容的(de)扁平引腳被很多板卡(kǎ)采用。安森美新近推出的NVMx和NVTx功率(lǜ)MOSFET就采用了緊湊型DFN5(SO-8FL)和WDFN8封裝(zhuāng),可最大(dà)限度地降低(dī)導通損耗,另外還具有低QG和電容,可將驅動器損耗降到最低的特性。

安森美SO-8扁平引腳封裝
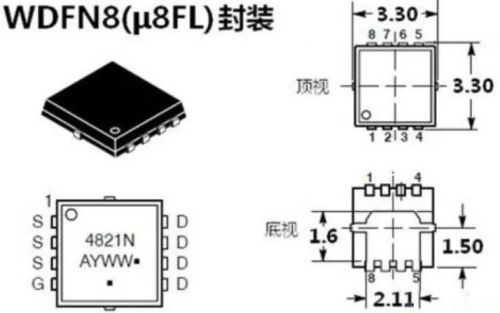
安森美WDFN8封裝
4、恩智浦(NXP)LFPAK和QLPAK封裝
恩智浦(原Philps)對(duì)SO-8封裝技(jì)術改進為LFPAK和QLPAK。其中LFPAK被認為是世界(jiè)上高度可靠的功率SO-8封(fēng)裝;而QLPAK具有體積(jī)小、散熱效率更高的(de)特點,與普通SO-8相比,QLPAK占用(yòng)PCB板的麵積為6*5mm,同時熱阻(zǔ)為1.5k/W。
&l